Overlay 장비
Overlay장비는 Metrology 장비의 일종으로 반도체 공정상 회로패턴치 적층되는 과정에서 하부패턴과 상부패턴간의 수직방향의 정렬상태를 계측하는 장비
초기 정렬에 오차가 발생한다면 Layer가 누적될수록 기하급수적으로 늘어나게 됨
Overlay 장비 연평균 성장률은 15%
21년 성장률은 52% 기록, EUV 적용의 영향으로 판단
Track 장비와 마찬가지로 노광기와 밀점하게 연동되어야 하는 장비 특성 상 ASML의 점유율 30%
국내에는 오로스테크놀로지가 TSV(Through Slicon Via) 패턴용 Overlay 장비를 생산 납품 중

Mask Inspection
EUV의 경우 투과형이 아닌 반사형 Photomask로 Inspection의 난이도가 높아지고 있음
16년 이후 연평균 27% 성장으로 노광기의 시장 성장률을 초과
21년 기준 Mask 검사 장비 분야에서 Lasertec의 시장점유율은 44% 육박
국내의 파크시스템의 원자현미경(AFM) 기반의 Photomask 검사장비를 납품

PR(Photo Resist)
PR은 빛과 반응성을 기반으로 웨이퍼 표면에 회로패턴을 구현하게 하는 화학물질
빛과의 노출 여부를 기준으로 용해되어 없어지거나 잔존하게 되며, 잔존되는 부분은 이후 Etching 공정에서 웨이퍼 표면을 보호하는 역할 수행
- 반도체 노광공장에서는 고해상도 패턴에 유리한 Positive Resist를 주로 사용
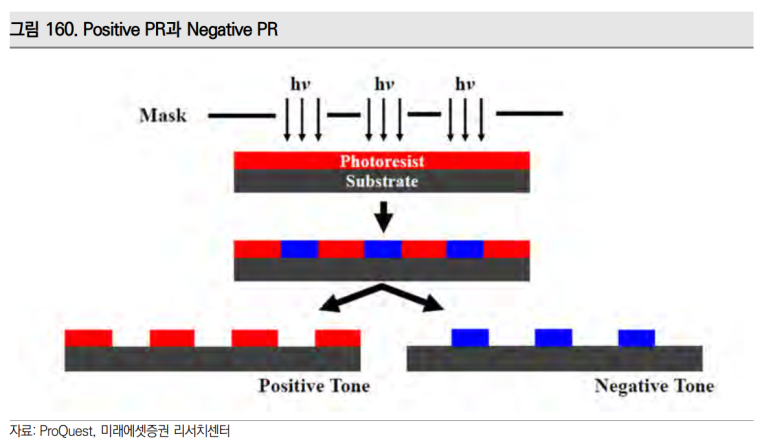
DNQ->CAR->MOR(Metal Oxide Resist)의 순서로 기술 발전
동진쎄미켐, SKMP 등의 EUV PR 진출 시도
TEL, 램리서치 등이 주로 경쟁
포토마스크(Photomask)
포토마스크는 유리 기판 위에 반도체 미세회로를 형상화 한 노광 공정용 핵심 부품
포토마스크의 패턴대로 Wafer의 PR에 새겨지게 됨
포토마스크의 패턴이 새겨지기 전을 블랭크마스크
블랭크마스크의 제조사는 Hoya, 아사히글라스, 국내에는 에스앤에스텍
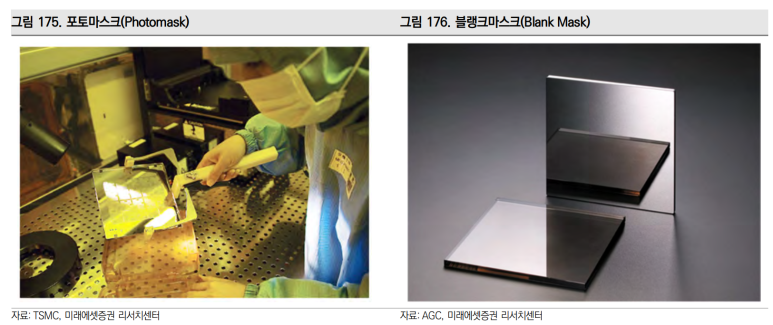
기존 노광 패터닝 방식은 포토마스크를 투과한 빛을 최종적으로 렌즈를 이용해 포토마스크 1/4면적으로 집광
EUV에는 렌즈가 아닌 거울을 통해 빛을 집광하고 포토마스크 또한 반사형 포토마스크 사용
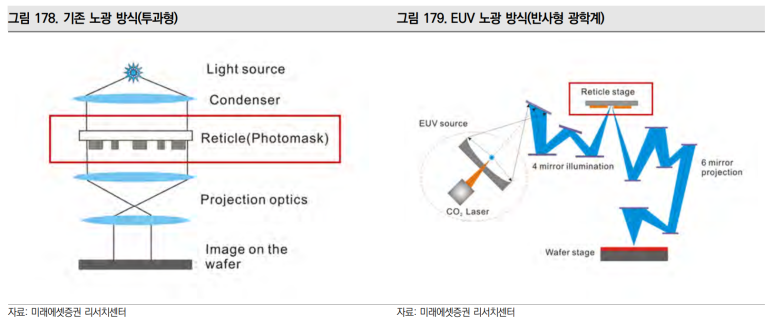
펠리클
펠리클은 포토마스크를 보호하기 위한 투명한 보호막
포토마스크는 고가의 부품으로 소모성인 펠리클을 장착해 보호
EUV용 반사영 포토마스크의 경우 제작이 어렵고 비싸며, DUV용 포토마스크에 비해 파티클의 기준이 월등히 타이트하기에 펠리클이 더 필요함
ASML과 일본 미쓰이화학이 일부 생산, 국내에는 에스앤애스텍과 에프에스티가 EUV용 펠리클 연구개발과 설비투자 진행
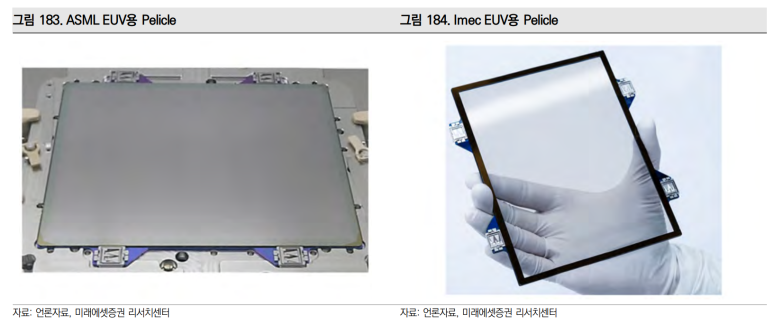
식각
식각 공정은 회로 패턴 형성을 위해 필요없는 부분을 선택적으로 제거하는 공정
가스를 사용하는 식각을 건식 식각(Dry Etching), 액상 화학물질(Etchant)를 사용하는 식각을 습식 식각(Wet Etching)이라고 함
습식식각은 등방성, 높은 선택성, 신속성, 경제성의 특징을 가짐
건식식각을 비등방성, 낮은 선택성, 늦은 처리속도, 정밀성, 낮은 경제성의 특징이 존재
등방성(Isotrpic) : 식각 대상이 노출된 모든 방향으로 식각되는 특징 <-> 비등방성
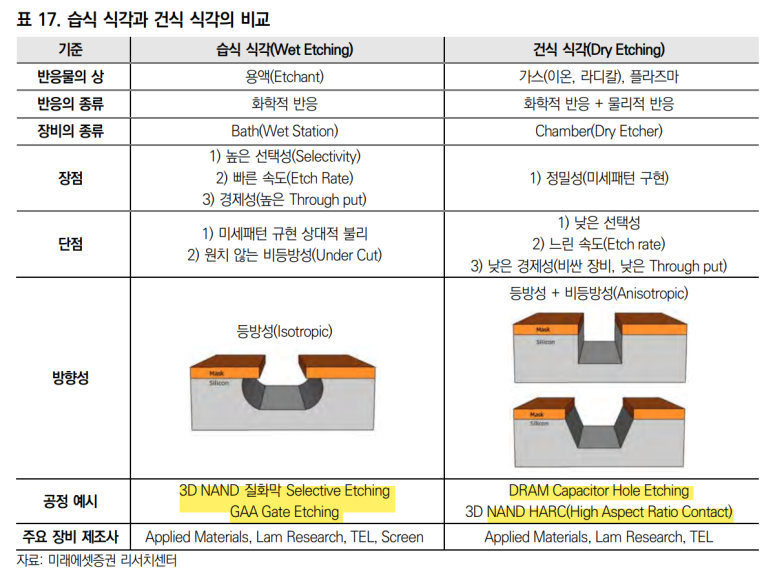
건식식각의 종류
Physical Dry Etching : 비활성 기체의 플라즈마에 높은 운동에너지를 가해 대상에 물리적으로 충돌, 화학결합을 끊어 제거하는 방식
플라즈마의 직진성이 강하기때문에 비등방성의 경향이 크게 나타남
Chemical Dry Etching : 반응성 기체가 플라즈마로 인해 형성된 라디칼이 반응물과 직접 반응, 기체상태로 기화해 제거되는 방식, 플라즈마 에칭이라고도 함
플라즈마에 Bias를 가하기 않기 때문에, 등방성 식각이라고도 부르며 선택성이 높은 편
반응성 기체로는 CF4, SF6, Ci2등이 사용
최근 GAAFET 공정에서 SiGe층의 선택적 식각방식에 대해 HF/H2O2 등을 이용한 식각 논의
Reactive Ion Etching(RIE): Chemical Dry Etching 장점인 선택성과 Physical Dry Etching의 장점인 이방성을 결합한 식각방식
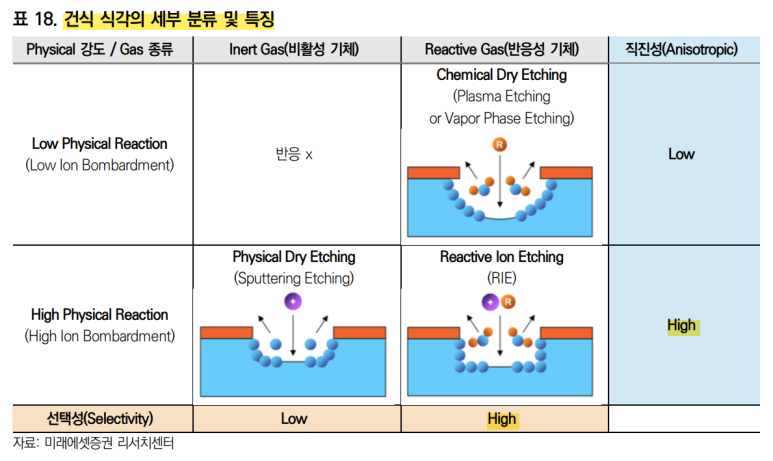
식각장비
Dry Etching은 플라즈마를 이용한 식각 방식으로 주로 RF플라즈마 사용
구동방식에 따라 CCP방식과 ICP방식으로 구분
CCP방식은 챔버 내 웨이퍼가 위치하는 하부전극과 상단부에 위치한 전극 사이 전력을 인가해 형성되는 축전 전기장에 의해 플라즈마 발생(장점 균일도, 단점 에너지 독립적 조절 불가)
ICP 방식은 챔버 외벽 또는 상단의 코일에 인가에 전력에 의해 발생한 유도 전기장으로 플라즈마 형성
식각속도 빠름, CCP 방식대비 균일도가 떨어짐
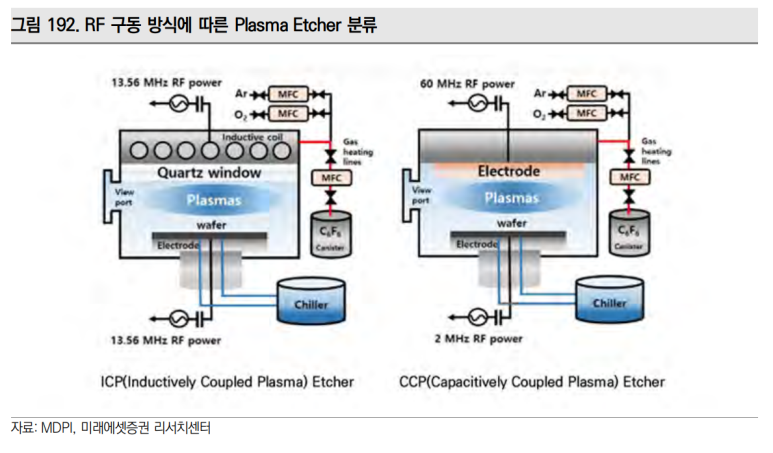
식각장비 시장규모는 199억달러로 증착 장비와 함께 가장 큰 시장
반도체 공정 발전과 패턴의 미세화 과정에서 식각공정이 실질적으로 주도
향후 메모리 고단화에 따라 유전체 식각 수요 증가
Logic 소자에서 FinFET -> GAAFET으로 트랜지스터 구조 변경 또는 전도체 식각의 수요 증가 촉진

램리서치, TEL, 어플라이드머트리얼즈 3사의 점유율이 91%
공정의 중요도가 높고 보수적인 장비구매가 불가피

규모가 작지만 국내의 건식식각 제조사는 에이피티씨 존재
SK하이닉스 향으로 DRAM, NAND향으로 납품
식각가스
건식식각의 원리는 기본적으로 식각가스가 박막과 반응해 박막의 고체 물질이 기체로 바뀌어 날아가는 원리
핵심은 CF계 식각가스에서 생성된 플라즈마와 이온이 SiO2박막과 반응해 기체로 날려보내지는 과정
대표적인 식각가스 제조사는 칸토덴카, 쇼와덴코, 아데카 등의 일본업체
국내의 경우 사용빈도가 높은CF계 국산화 생산
SK쇼와덴코 및 후성은 CF계 Gas
원익머트리얼즈는 SiF6, SiCI4, 오션브릿지 CF4, HBr을 생산 유통
NF3은 식각보단 챔버세정용으로 사용(SK머트리얼즈 글로벌 생산능력 1위)

습식식각
습식식각은 액체 상태의 화합물인 Wet Echant를 통해 목표로하는 물질을 제거하는 공정
건식식각보다 빠른 속도와 높은 선택성이 장점
습식식각의 대표적인 예로 3D NAND 공정에서 SiO2/Si3N4 적층 구조 형성이후 Si3N4를 선택적으로 제거하는 공정으로 선택성이 높아야 하기 때문에 이를 HSN 식각이라고 한다.
삼성전자가 128단의 낸드를 싱글스택으로 할 수 있었던 이유는 건식식각을 통한 Hole Etching에서의 기술격차 뿐만 아니라 128단의 Si3N4 박막을 선택적으로 제거할 수 있는 H3PO4 레시피 개발이 결정적
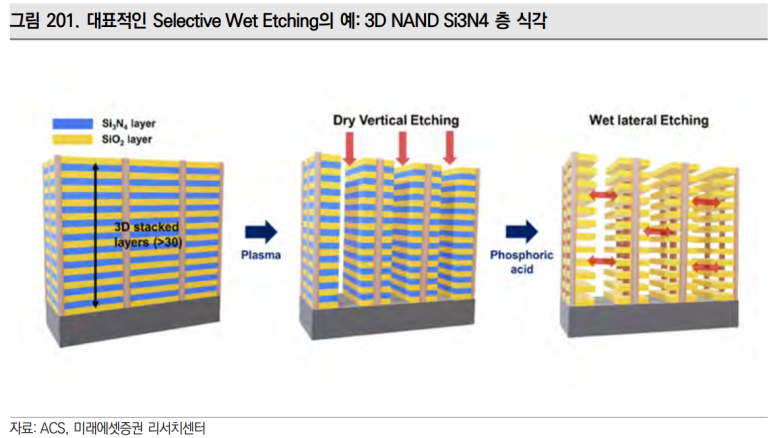
국내 대표적인 Wet Etchant 제조사는 솔브레인이며 HF, BOE뿐만 아니라 HSN H3PO4 생산
사용량 면에서 HF보다 많은 H2O2의 경우 한솔케미칼
GAAFET에서는 Etchant가 H2O2의 사용량이 매우 많음

Focus Ring
포커스링은 건식식각 공정과정에서 Dry Etcher 또는 플라즈마 CVD 챔버내에서 Wafer를 고정하는 역할
포커스링의 구조상 웨이퍼와의 경계면에서 플라즈마가 집중되는 현상이 발생
이를 방지하기 위해 의도적으로 포커스링의 높이를 웨이퍼보다 소폭 높게 제작
포커스링의 안쪽 경계면은 항상 빠르게 식각되어 높이가 낮아지고, 간격이 벌어져 상기한 플라즈마 왜곡을 초래하게 된다. 포커스링을 주기적으로 교체해야하는 이유
CVD SiC Ring의 사용은 SiC의 내구성도 좋지만, SiC 상부면에 도포함으로해서 하단의 소재는 저유전 소재를 사용할 수 있게 되고 링 전체의 Capatance를 낮추는 효과
3D NAND의 경우 홀 에칭을 위해 플라즈마 에너지가 높은 CCP 건식 식각을 이용하거나 ICP를 사용하더라도 플라즈마 밀도를 높인다.
즉 3D NAND의 단수 증가는 플라즈마 에너지의 강화 -> SiC 링 수요의 증가
국내 Si/SiC Focus Ring 제조사는 티씨케이, 하나머티리얼즈, 월덱스, 케이엔제이

Dry Strip(Ashing)
노광과 식각이 끝난 이후 PR을 제거하는 공정을 Ashing 공정이라고 함
박막을 제거한다는 의미에서 광의의 식각
PR Strip 과정중의 플라즈마가 이미 식각이 끝난 웨이퍼 표면을 손상시키지 않아야 하기 때문에 고난이도 플라즈마 컨트롤을 요하는 공정
PR Strip 전용장비 기준으로는 국내의 피에스케이가 글로벌 점유율 41%로 1위
시장 내에서도 피에스케이 점유율이 가장 크기에 IDM/파운드리의 케파 투입패턴과 유사한 궤적

Bevel Etcher
웨이퍼 가장자리 부분을 Bevel 이라고 한다. 반도체 공정을 거치면서 Bevel 부분의 불필요한 잔여물과 박막이 쌓이게 됨
이를 제거하기 위한 장비를 Bevel Etcher
피에스케이가 Bevel Etcher에 대한 국산화 시도
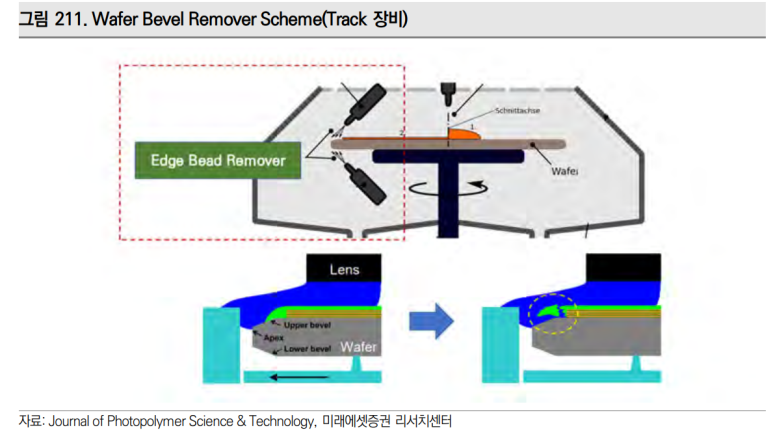

Disclaimer
- 당사의 모든 콘텐츠는 저작권법의 보호를 받은바, 무단 전재, 복사, 배포 등을 금합니다.
- 콘텐츠에 수록된 내용은 개인적인 견해로서, 당사 및 크리에이터는 그 정확성이나 완전성을 보장할 수 없습니다. 따라서 어떠한 경우에도 본 콘텐츠는 고객의 투자 결과에 대한 법적 책임소재에 대한 증빙 자료로 사용될 수 없습니다.
- 모든 콘텐츠는 외부의 부당한 압력이나 간섭없이 크리에이터의 의견이 반영되었음을 밝힙니다.
